DME8061Fully Automatic MUSUBI Dry Etcher
チップ抗折強度を向上するMUSUBI対応ドライエッチャ
- Φ300 mmウェーハ対応
- DBG
- SDBG
- 薄化
- ストレスリリーフ
プラズマストレスリリーフによる抗折強度の向上
プラズマによる非接触のストレスリリーフを実施可能なドライエッチャです。
研削面に残った研削ダメージ層を除去し、抗折強度を向上します。
プラズマゲッタリングによる金属汚染の防止
ストレスリリーフ後、プロセスガスを切り替え、連続でゲッタリング※処 理が可能です。研削面にゲッタリング層を形成し、デバイス面の金属汚染 を抑制します。

MUSUBI対応
複数装置を連結するクラスターシステム「MUSUBI」に対応しています。お客様の製造プロセスに合わせた装置構成が可能です。また装置間の搬送を自動化し、ウェーハ破損リスクの低減やスループット向上を実現します。
例:MUSUBI_002
DMG8762(グラインダ/ポリッシャ)+DME8061(ドライエッチャ)+DMM9200(ウェーハマウンタ)接続のプロセス例
SDBG(Stealth Dicing Before Grinding) プロセス後のチップ表面に対し、DME8061でプラズマストレスリリーフ+プラズマゲッタリング処理を行うことで、チップ抗折強度の向上とゲッタリング効果の両立を実現可能です。
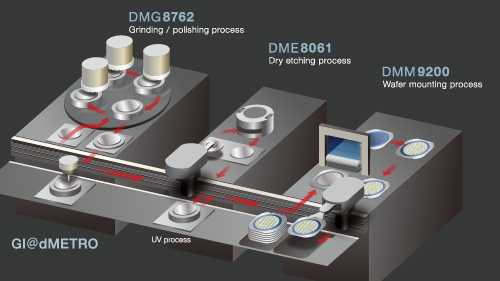
ワークフローシステム
- グラインダポリッシャからワークを受け取る
- ロボットでワークをドライテーブルへ
- ワークを乾燥
- アームでチャンバー内チャックテーブルへ
- プラズマストレスリリーフ/ゲッタリング
- アームでワークをポジショニングテーブルへ
- ロボットがワークをマウンタに受け渡す
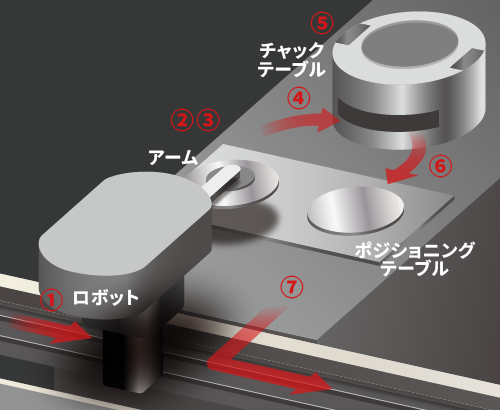
仕様
| 仕様 | 単位 | DME8061 | |
|---|---|---|---|
| 研削可能ウェーハ径 | mm | Φ300 | |
| プロセスガス | - | SF6, Ar | |
| 装置寸法(W×D×H) | mm | 1,400 × 2,200 × 1,800 | |
| 装置質量 | kg | 約2,600 | |
※ ガス除外設備はお客様にてご準備お願いいたします。
※ ご使用にあたっては、あらかじめ標準仕様書をご確認下さい。
※ 各事項、および仕様は改良のため、断りなく変更することがあります。
製品ラインナップ
DME8061Fully Automatic MUSUBI Dry Etcher
お問い合わせ
ご質問・ご相談等ございましたら、お気軽にお問い合わせ下さい。





